Описание решения:
В процессе производства полупроводниковых устройств наличие дефектов может различным образом влиять на качество продукции, например, наличие металлических включений в ключевых местах может вызвать короткое замыкание устройства, органические и неорганические отложения, внесенные в процессе очистки растворов, могут привести к неудачам в фотолитографии, ионной имплантации, осаждения и т. д., что в свою очередь может привести к несоответствию геометрии кристалла и дизайна. Поэтому процесс производства кристаллов требует реального временного контроля над дефектами и анализа происхождения множества повторяющихся дефектов для быстрого определения источников включений и дефектов, чтобы контролировать и корректировать соответствующие технологии и обеспечить стабильное качество продукции.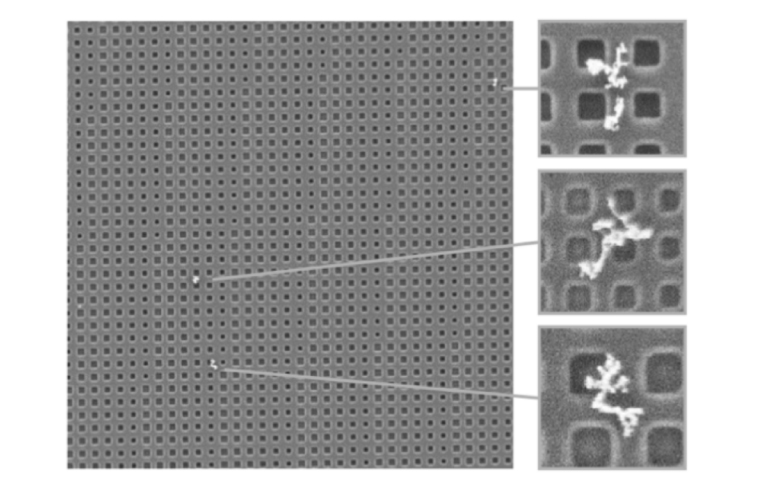
Нак МикропучокFE-1050 - термоэмиссионный сканирующий электронный микроскоп с разрешением до1kV (напряжение ускорения) в пределах1.5nm, способный непосредственно изображать материалы, чувствительные к электронному пучку, минимизируя повреждения образца от электронного облучения.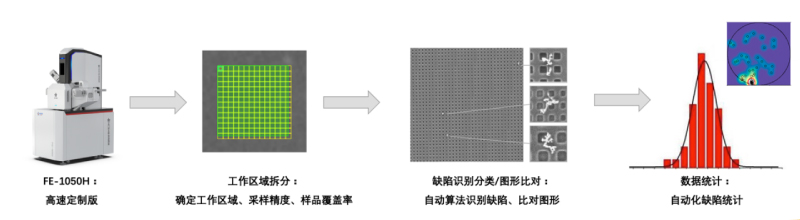
Серия FE-1050 сканирующих электронных микроскопов имеет просторную главную камеру и пятиосевой образцовый стол, способный принимать образцы размером до φ300мм*50мм, весь комплекс оборудования предоставляет до27 интерфейсов детекторов, обеспечивая максимальное удобство для наблюдения и анализа пользователей. Может быть модернизирован для высокоскоростного сбора данных, скорость сканирования после модернизации может достигать от50-100раз, что более подходит для сценариев сканирования больших площадей и автоматического анализа дефектов.
Кроме того, для пользователей с особыми потребностями в обнаружении дефектов предоставляются услуги по разработке индивидуальных алгоритмов, включая, но не ограничиваясь, традиционным машинным зрением, машинным обучением и т. д. Форма индивидуального обслуживания гибкая, сроки разработки могут быть своевременно скорректированы в зависимости от обновления продукции и производственных возможностей пользователей.